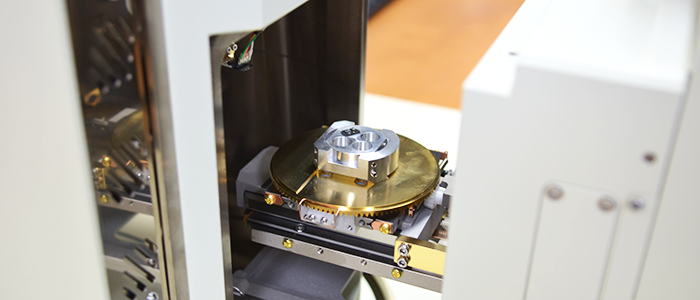
試料前処理
![]() FIB断面加工・FIB薄膜加工・FIBμ-サンプリング・イオンミリング等を利用し、前処理実施します。
FIB断面加工・FIB薄膜加工・FIBμ-サンプリング・イオンミリング等を利用し、前処理実施します。
表面形状観察
![]() 光学顕微鏡観察
光学顕微鏡観察
・数十~数百倍の観察
走査型電子顕微鏡(SEM)観察
・~10,000倍程度の観察
・低真空モードでの観察
・反射電子像観察
電界放出走査型電子顕微鏡(FE-SEM)観察
・~100,000倍程度の観察
・試料サイズ:3×5mm
走査型透過電子顕微鏡(STEM)観察
・高倍率像観察(100~1,000万倍)
・2次、散乱、透過電子像の観察
原子間力顕微鏡(AFM)観察
・表面形状の高分解能観察
・試料サイズ:Φ120mm
・3次元像、面粗さ測定、線粗さ測定
表面分析
![]()
SEM-EDX、FE-SEM-EDX
・微小部の元素分析(B~U)
・点分析、ライン分析、マッピング分析
STEM-EDX
・微小部(数十nm~)の元素分析(B~U)
・点分析、ライン分析、マッピング分析
二次イオン質量分析装置(SIMS)
・数十μm領域での高感度分析
・深さ方向のプロファイリング
・標準試料を用いた定量分析可能
飛行時間型二次イオン質量分析装置(TOF-SIMS)
・Φ60mmまでの大面積試料が測定可能
・深さ方向のプロファイリング
マイクロオージェ電子分光分析装置(μ-AES)
・最表面の元素分析
・元素組成比の確認が可能
・マッピング分析
顕微レーザラマン分光装置等による表面分析
・FT-IRの補完分析に(Φ20μm以下の微小部の有機化合物分析)
・マッピングによる有機化合物分析
*上記内容には技術提携ラボにて実施する項目も含まれます。
*上記に記載のない分析装置、分析手法についてもお問い合わせください。











